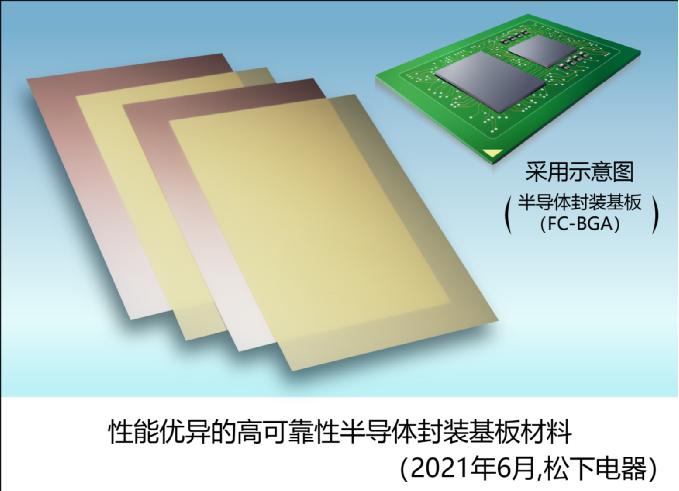
松下电器产业株式会社机电解决方案公司实现了性能优异的“半导体封装基板材料(产品编号:R-1515V)”的产品化,将于2021年7月批量生产。该产品可在封装时利用低热膨胀性抑制翘曲,并且利用优越的伸缩性和缓冲性来减轻对焊球的应力。
物联网、人工智能技术和车联网等应用的发展皆需使用到高性能、高集成度半导体芯片,正因为如此,半导体封装正朝着大型化和2.5D封装[1]中常见的高密度化方向发展,需具备优异的封装可靠性。
松下一直致力于研发主板用基板材料、半导体封装基板(Substrate)材料和半导体封装材料等多种材料。此次,松下综合运用此类自主研发技术,开发出具有高可靠性的半导体封装基板材料。若想提高封装可靠性,我们需要在封装IC芯片和基板(半导体封装)时抑制翘曲的产生,并且在贴装半导体封装体和主板(主板级SMT[2])时降低施加于焊球的应力。
本次研发的材料通过抑制热膨胀系数(CTE[3]),使之接近于IC芯片的低热膨胀系数以抑制翘曲的产生,提高了半导体封装的可靠性。并且利用优异的板厚精度,使基板和IC芯片的贴合更为稳定,进一步提高了半导体封装的可靠性。在主板级SMT中,兼具良好的伸缩性和缓冲性,以缓和因热膨胀差异而对焊球施加的应力,从而提高贴装可靠性。
【特点】
1. 利用低热膨胀性,通过接近IC芯片的热膨胀系数抑制翘曲,减少了IC芯片封装(半导体封装)时的不良问题
2. 确保低热膨胀性,同时利用兼具树脂的伸缩性和缓冲性的应力缓和技术,提高主板级SMT的可靠性
3. 板厚精度优异,使基板(核心材料)和IC芯片的互连更为稳定,进一步提高半导体封装的可靠性
【用途】
CPU[4]、GPU[5]、FPGA[6]、ASIC[7]等的FC-BGA[8]封装
【备注】
发布于The 2021 IEEE 71st Electronic Components and Technology Conference(2021年6月1日~7月4日)。
【特点的详细说明】
1. 利用低热膨胀性,通过接近IC芯片的热膨胀系数抑制翘曲,减少了IC芯片封装(半导体封装)时的不良问题
基于在电子电路基板材料研发中培育的树脂设计技术,研发出4ppm(本公司测量值)的低热膨胀系数材料。通过更接近IC芯片(半导体)的低热膨胀系数,抑制因互相的热膨胀系数差异而产生的翘曲,提高基板和IC芯片的封装可靠性。
2. 确保低热膨胀性,同时利用兼具树脂的伸缩性和缓冲性的应力缓和技术,提高主板级SMT的可靠性
通过仿真模拟,依托自主的树脂设计技术,研发出确保低热膨胀性并且兼具伸缩性和缓冲性的材料。如此可以吸收及分散施加于半导体封装体和主板之间的焊球上的应力,不影响半导体封装质量,并提高主板级SMT的可靠性。
3. 板厚精度优异,使基板(核心材料)和IC芯片的互连更为稳定,进一步提高半导体封装的可靠性
利用在电路基板材料研发中培育的树脂流动控制技术,可在抑制树脂流动的同时确保良好的成型性,实现极小的公差管控和均匀性控制。使基板(芯板材料)和IC芯片的互连更为稳定,进一步提高半导体封装的可靠性。
【特性表】
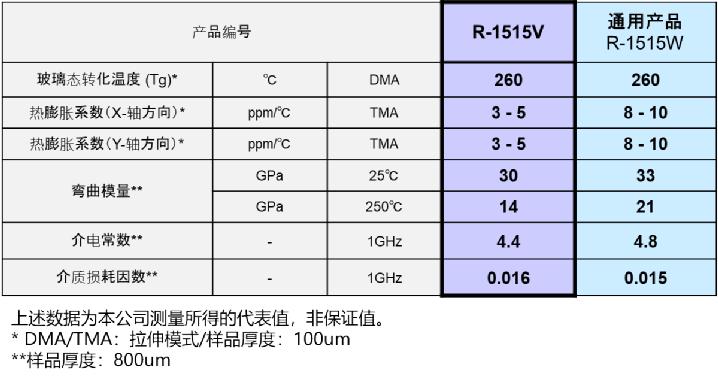
【产品详细信息】
https://industrial.panasonic.cn/ea/products/electronic-materials/circuit-board-materials/megtron-gx/lexcmgxr1515vad=press20210622zh
免责声明: 凡注明来源本网的所有作品,均为本网合法拥有版权或有权使用的作品,欢迎转载,注明出处。非本网作品均来自互联网,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责。