保护 USB 端口、不同电源供电的设备的开关电路以及高侧负载开关免受浪涌影响,都依赖于双向电压阻断和电流传导。到目前为止,设计人员只能使用两个在共源极配置中背对背连接的N 型MOSFET来实现此目的。该方法涉及两个组件,并且由于导通电阻 (RDS(on))、安全工作区 (SOA) 和其他特性而受到限制(图 1)。双向氮化镓 (BiGaN) 开关是一种创新解决方案,可降低功耗并大大减少占地面积。
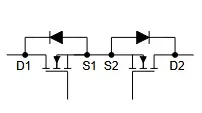
图 1:使用背对背连接的 N 型 MOSFET 来提供双向电压阻断是一个有点大的解决方案,具有性能限制(来源德州仪器)
由于其垂直结构,MOSFET 具有很大的集成困难。在单个芯片上集成两个 FET 非常具有挑战性,其成本、RDS(on) 和电压值对于大约 30 V 及以上的器件而言是的。相比之下,由于 GaN 高电子迁移率场效应晶体管 (HEMT) 的侧面结构并且没有寄生二极管,因此制造单片双向 GaN 开关非常简单。
更低的泄漏和空间要求
在智能手机电池管理系统中使用过压保护 (OVP) 开关旨在限制总损耗,同时保持尽可能小的占地面积。在这个特定应用中,断路器阻断传导电压或电流,而不需要在两种状态之间频繁切换。因此,栅极充电不会造成明显的开关损耗。总损耗基本上仅由传导损耗以及器件的总导通电阻决定。
传统上,OVP 功能是通过背对背连接的分立 MOSFET 来实现的。新的 BiGaN 器件技术的尺寸比普通的单 GaN HEMT 稍大。与在双向开关配置中采用两个分立器件相比,该设计的导通电阻要低得多,并且提供了更紧凑的解决方案。
在传统 MOSFET 中,RDS (导通)是器件完全导通时漏极和源极之间的电阻。 BiGaN器件的对应值为RDD(on),即器件完全导通时两个漏极之间的电阻。该封装可以对导通电阻做出重大贡献。 BiGaN 器件的横向结构提供的寄生电阻,有助于减少传导损耗和热耗散。其紧凑性还保证了出色的“导通电阻*面积”(Ron*A) 性能,这是系统小型化的一个重要因素。,单个 BiGaN 器件取代了两个 MOSFET,从而显着减少了占地面积并简化了材料清单。
评估 BiGaN 器件的个选择是保留现有的面积和占用空间,这大大降低了导通电阻值,从而限制了充电时的温升。另一方面,BiGaN 显着减少了 OVP 功能的占地面积,同时保持良好的导通电阻,从而保持良好的效率。图 2 突出显示了通过使用 BiGaN 器件调节智能手机电池电量所获得的结果。

图 2:BiGaN 方法在手机中取得的改进百分比值
SOA 和分散
安全操作区 (SOA) 是负载开关应用中的一个重要元素。此参数指定允许设备正常运行而不会损坏或性能下降的电压和电流组合。限制 SOA 的因素包括 R值以及某些封装和散热方面。由于阈值电压 (Vth) 的负温度系数,提高硅 MOSFET 的 SOA 很复杂。由于 GaN 器件中的 VTH 值随温度变化较小,因此 BiGaN 技术即使在高温下也能保持更好的 SOA 性能。
使用双向电压阻断的应用中的另一个重要因素是栅极泄漏。 Si MOSFET 具有出色的栅极漏电性能。在这些器件中,栅极通过栅极电介质(氧化物)与沟道绝缘,从而在 25 °C 时漏电流小于 μA。当温度升高时,Si MOSFET 的 Vth 值会下降,而漏电流会增加。
BiGaN 器件具有独特的栅极结构,可以将其描述为两个背对背连接的二极管。如果没有适当的控制,BiGaN 器件的栅极泄漏会比 Si MOSFET 更多。这种需求对于在智能手机中实施该解决方案至关重要。
BiGaN 器件的控制
与 Si 背靠背 MOSFET 一起使用的电流驱动器也可以与 BiGaN 技术一起使用,前提是驱动电压为 5 V。就智能手机而言,大多数充电器 IC 与具有 5 V 栅极驱动器的 HEMT GaN 晶体管兼容。
栅极电压必须至少高于 Drain1 或 Drain2 的 V th (~1.7 V) 才能开启 BiGaN 器件。要关闭它并阻止任一方向的电流流动,从栅极到漏极的电压(VGD1和V GD2)必须小于 V th或栅极接地(地)。 BiGan 在 5 V 应用中可由电荷泵驱动(图 3)。当 EN 为低电平时,栅极电压为零,BiGaN 将关闭。当 EN 为高电平时,栅极电压将被泵压至 V IN + 5V,BiGaN 将导通,V OUT将等于 V IN。
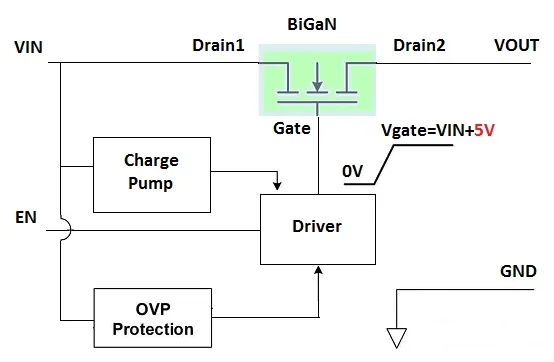
图 3:BiGaN 器件可使用电荷泵和标准 5 V 栅极驱动器 IC 在 5 V 应用中打开和关闭
具有 5 V 栅极驱动器的 IC 通常仅限于在智能手机应用中使用。此类应用使用电压约为 10 V 的驱动器,旨在从 Si MOSFET 获得尽可能的 RDS (导通)值。这些驱动器的驱动电压高于栅极额定值,因此不能直接驱动 GaN HEMT。在这些应用中,可以使用带有齐纳二极管(D1 和 D2)的终端电路在电压低于 6V 时连接 V GD (图 4)。为了实现漏极到栅极阻断,二极管 D4 和 D5 的击穿电压大于 40 V。
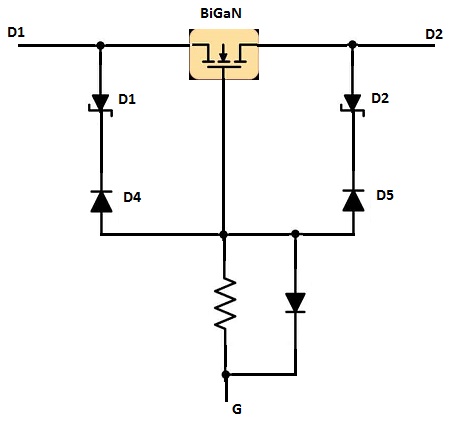
图 4:由于采用齐纳二极管钳位电路,BiGaN 器件可以与通常用于 Si MOSFET 的更高电压栅极驱动器一起运行