O 引言
随着半导体生产制造工艺的不断改进,器件模拟和工艺模拟的与实际工艺流程的吻合性将越来越好,使产品的模拟结果更具有实用性、可靠性。随着现代工艺水平的提高与新技术的开发完善,功率VDMOSFET设计研制朝着高压、高频、大电流方向发展,成为目前新型电力电子器件研究的重点。
本文设计了漏源击穿电压为500 V,通态电流为8 A,导通电阻小于O.85 Ω的功率VDMOSFET器件,并通过工艺仿真软件TSUPREM-4和器件仿真软件MEDICI进行联合优化仿真,得到具有一定设计余量的参数值。
1 VDMOSFET工作原理
VDMOSFET是电压控制器件,在栅极施加一定的电压,使器件沟道表面反型,形成连接源区和漏区的导电沟道。基本工作原理如图1。
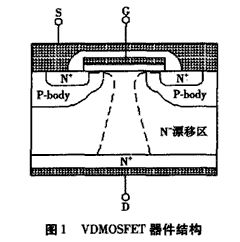
当栅源电压VGS大于器件的阈值电压VTH时,在栅极下方的P型区形成强反型层,即电子沟道,此时在漏源电压VDS的作用下,N+源区的电子通过反型层沟道,经由外延层(N-漂移区)运动至衬底漏极,从而形成漏源电流。
2 参数设计
2.1 外延层电阻率和厚度
外延层的电阻率ρ越大(掺杂浓度Nepi越小),则器件的击穿电压越大。然而,导通电阻Ron也相应增大。因此,在满足击穿要求的前提下,ρ越小(Nepi越大)越好;而从导通电阻的角度考虑,又限定了该电阻率的值。
2.2 阈值电压
影响阈值电压的因素主要是P-body浓度NA,栅氧化层厚度tox和栅氧化层的面电荷密度Qss,主要通过调整P阱注入剂量和推阱时间来调节阈值电压Vth。此外,栅氧化层厚度tox受栅源击穿电压的限制,tox≥VGS/EB,SiO2的临界电场EB一般为5×106~107 V/cm;由此算得tox的值为30 nm~60 nm;由于P-body为非均匀掺杂,VTH难于用公式准确计算,因此栅氧化层厚度tox和pbody浓度的值需借助于计算机仿真优化来确定。
2.3 导通电阻
对于功率VDMOSFET器件,在不同耐压下,各部分电阻占导通电阻的比例是不同的。
2.4 开关时间
优化开关时间的方法包括两个方面:减小多晶硅栅的电阻RG和减小输入电容Cin。在输入电容中,密勒电容CGD是主要的影响因素。减小多晶硅的电阻RG可以在工艺过程中提高多晶硅的掺杂剂量,在版图设计过程中增加栅极多晶硅与栅极铝引线的接触孔;减小输入电容Cin主要是减小密勒电容CGD。
3 横向结构设计
3.1 元胞结构选取
由于正三角形元胞的电场容易集中,导致漏源击穿电压的降低;六角形元胞的对角线与对边距的比值为,小于方形元胞的对角线与边长的比值,电流分布的均匀性好,曲率效应小;圆形元胞牺牲率(即A‘/Acell,其中A’为元胞边缘结合处电流不能流过的无效区面积,Acell为元胞总面积)大于六角形元胞。
3.2 栅电极结构
功率VDMOSFET由很多小元胞单元并联组成。而由于栅极多晶硅电阻的存在,使得在一定的栅极偏压下,离栅极压焊点较远的元胞沟道不能充分开启。本文所设计的功率管从压焊点处引伸3条金属条并与下面的多晶硅相接触。

3.3 结终端结构设计
传统的场板与场限环相结合的结终端结构如图3所示。设计时,如果场板和保护环的间距过大,场板下的耗尽层扩展到保护环之前PN结就首先击穿,保护环将起不到作用。

本文研究的新型结终端结构(如图3所示),是采用场板覆盖保护环的方式,避免了传统场板与场限环结构的设计难题,而使其简单化。

这种结构在版图设计上通过增加铝场板的长度来实现,比较容易控制,使得金属覆盖过离主结近的场限环,它不仅起到了场板和场限环的效果,又避免了传统结构在场板的边缘产生新的电场峰值,避免了电压在场板边缘和场限环之间的提前击穿。
4 仿真优化结果
通过工艺仿真软件TSUPREM-4和器件仿真软件MEDICI进行联合仿真,不断调整工艺参数,优化元胞和结终端结构,终使各项参数的仿真指标满足设计要求(详见表1)。

5 器件研制结果分析
本产品研制按照功率VDMOSFET正向设计的思路,选取<100>晶向的衬底硅片,采用硅栅自对准工艺流程,首次流片遵照计算机仿真优化的工艺条件,进行工艺摸底;针对测试结果,逐步进行局部工艺调整,终使得产品指标满足设计要求。
(1)次流片
产品测试结果表明:产品的击穿电压均值为438.82 V,并且普遍低于设计要求的500 V。经分析,其可能存在的原因是:由于衬底反扩散较大,从而导致外延层电阻率偏低,使得击穿电压降低。
(2)第二次流片
测得的击穿电压平均值551.68 V,大于500 V,满足设计要求。改进方案:对于高压功率VDMOSFET器件,JFET电阻在导通电阻的组成部分中,占有相对较大的比重。
(3)第三次流片
测试结果表明:在减小P-body推结时间后,导通电阻小于850 mΩ,满足设计要求;虽然产品的击穿电压(均值536 V)有所下降,但仍满足大于500 V的设计要求;其余静态参数、动态参数指标也均满足设计要求。
6 结束语
本文在计算机仿真优化的基础上,通过对产品测试结果的分析及工艺条件的调整,终实现了成功研制。相对于传统的流水线小批量投片、反复试制的方法大大节约了研制成本,收到了事半功倍的效果。
免责声明: 凡注明来源本网的所有作品,均为本网合法拥有版权或有权使用的作品,欢迎转载,注明出处。非本网作品均来自互联网,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责。