随着人们对嵌入式手持终端设备功能水平要求的不断提高,手持终端的功耗也在不断增高。与之相矛盾的是,手持终端的尺寸却在不断缩小,工作时间也在不断延长,使嵌入式手持终端电源系统管理面临越来越大的压力。如何设计出性能稳定、功耗低的电源管理系统已经成为嵌入式手持终端设备开发的难点之一。电源管理系统(Power Management,PM)是电子系统中必不可少的技术。由于采用了先进的电源管理技术,移动电话、PDA等产品得到了广泛的应用。如果不采用完善的电源管理技术,移动电话的通话时间可能不超过2 min.在正常模式下,CPU以及外围部件都需要供电。外围部件主要包括Flash、SDRAM、GPRS、GPS、无线模块、LCD、触摸屏等部分。CPU电压分为2组:电压为1.2 V;I/O引脚电压为3.3 V.USB和GPS供电电压为5 V.LCD的供电电路比较复杂,需要专用的驱动芯片为其供电。由于现在几乎所有的手持终端都是彩屏,作为调节LCD背光亮度的LED也需专门的驱动电路。其余部分(如GPRS、无线模块、音频等)都为3.3 V.
设计电源的工程师一旦为应用系统选定电路布局之后,便要面对以下的问题:究竟需要多少功率转换级?转换器究竟应采用硬开关还是软开关?由于这两个问题的关系,选用哪一类开关及整流器便显得极为重要。大部分砖块式转换器都采用功率 MOSFET 组建电源开关及低电压同步整流器。经过多年的发展,MOSFET 技术已相当成熟,现在系统设计工程师甚至可以选用具有标准导通状态电阻 (RDS-ON) 的沟道型芯片及极间电容较低的平面型芯片。电压及电流的额定值一旦确定之后,选用哪一类芯片便要看芯片的损耗究竟来自开关速度还是来自导通状态电阻。近来,CDG/CGS比率受到系统设计工程师高度的重视,因为这个比率是显示高功率、高频率的半桥式功率转换级是否出现击穿情况的指标。
开关频率与电磁干扰之间的适当平衡
开关频率也就是说变频器输出的电压其实是一系列的脉冲,脉冲的宽度和间隔均不相等。其大小就取决于调制波和载波的交点 .开关频率越高,一个周期内脉冲的个数就越多,电流波形的平滑性就越好,但是对其它设备的干扰也越大。
电磁干扰是人们早就发现的电磁现象,它几乎和电磁效应的现象同时被发现,1981年英国科学家发表"论干扰"的文章,标志着研究干扰问题的开始。1989年英国邮电部门研究了通信中的干扰问题,使干扰问题的研究开始走向工程化和产业化。电磁干扰源包括微处理器、微控制器、传送器、静电放电和瞬时功率执行元件,如机电式继电器、开关电源、雷电等。在微控制器系统中,时钟电路是的宽带噪声发生器,而这个噪声被扩散到了整个频谱。随着大量的高速半导体器件的发展,其边沿跳变速率很快,这种电路将产生高达300 MHz的谐波干扰。
好的功率转换器除了要有较高的开关频率之外,也要顾及系统的转换效率及电磁干扰。换言之,各方面都要兼顾,力求取得适当的平衡。开关频率越高,电源开关、整流器及控制电路的开关损耗便会越高。以模块式DC/DC转换器来说,只要提高开关频率便可采用较小的滤波器及能源存储元件,这是提高开关频率的好处。但以采用硬开关的系统来说,电源管理芯片的高频信号会出现较多谐波,令芯片与散热器或供电层之间的杂散电容出现大量位移电流。这些位移电流甚至会流入变压器的线圈电容,甚至会造成共模干扰。
以采用DC/DC转换器的控制与驱动系统来说,工程师设计集成电路及其封装时,已考虑到砖块转换器的结构而做出适当的调节。以电路的设计来说,更高的技术集成度、板上高电压稳压器、更高时钟频率以及可编程压摆率的低射穿驱动器都适合新一代的设计采用。散热是设计电源管理IC需要面对的主要问题。电源管理IC内置的驱动器、稳压器通道晶体管以及电源开关都设于裸片的外围,紧贴焊盘。这些内置芯片及晶体管进行操作时,热能会传遍整颗裸片,形成一幅由不同等温线组成的热能“分布图”。若不同的晶体管分别设于不同的等温线之上,部分次电路 (尤其是温度必须相匹配的差分电路) 便会在性能上受到影响。集成电路的线路布局必须做出调整,例如,芯片正常操作时,不同晶体管在同一时间内都处于相同的温度之下,但要取得这样的效果并不容易。电源管理IC的缩微图显示部分芯片经常采用交叉耦合的设计,以便可以在初期阶段减少热能的耗散量。
采用合适的封装
LLP封装

图1:LLP封装的正面及反面
图1显示的无引线导线封装 (LLP? 是一种有导线的芯片级封装 (CSP),其优点是可以提高芯片的速度,降低热阻以及占用较少印刷电路板的板面空间。由于这种封装具有体积小巧且外型纤薄的优点,因此适用于设有模块式DC/DC转换器、元件较为密集的多层式印刷电路板。
LLP 封装有如下的优点:低热阻;较少寄生电子响应;可以充分利用电路板板面空间,以支持更多其他功能;封装纤薄、轻巧。
集成电路的封装设计过程涉及很多繁复的工序,例如要为散热及机械系统建立模型,以便进行测试;此外,进入生产及测量阶段之后,裸片上的实际测量数字或模拟图所示的热能分布数字必须与有限接线电路模型 (finite element model) 互相比较。一般来说,我们只要针对设于新封装内的测试裸片,测量其二极管的正向压降,便可取得裸片的实际测量数字。很多不同的远程二极管温度传感器芯片都采用这种经过长期测试、证实有效的技术,以便能够为新一代的微处理器、数字信号处理器及数字特殊应用集成电路提供更可靠的防护。我们也可利用测试裸片内置的一个或多个二极管将热能传入,以核实裸片的热特性。
封装设计及热特性
芯片封装有两种热特性,分别以 θJA及θJC作为代号表示。按照定义,θJA是封装热阻的总量,亦即封装内部及外部的热阻总和,其数值可以利用以下公式计算出来:
θJA=θJC+θCA=(TJ-TA)/P
其中,θJC:(TJ-TC)/P,结面至机箱的导热性热阻 (℃/W);θCA:(TC-TA)/P ,机箱至环境的对流热阻 (℃/W);P:I(电流)×V (电压),芯片的热量耗散 (W);TJ:芯片结面的平均温度 (℃);TA:环境的平均温度 (℃);TC:封装上某一指定位置的机箱温度 (℃)。
在封装物料的底层内,θJC热阻大部分属于导热性热阻,热阻大小主要取决于封装的配置。若热能流向与封装的物料层平面成 90°角,θJC可以利用以下公式计算出来:
∑ti/(ki Ai)
在以上公式之中,ti是指每一封装物料层的厚度,ki是指其导热性,而Ai是指导热面的面积。上述封装物料包括连接裸片的物料、导线、裸片表层涂料以及模封或封装绝缘物料。
θCA是外在环境的对流热阻,其大小主要由周围环境、封装边缘状况及共轭热能传送等因素决定。以LLP封装来说,结面至周围环境的热阻较低,只要降低印刷电路板导热面至结面的热阻,便可减少大部分结面至周围环境的热阻。图2 的横切面显示裸片焊接在连接裸片的焊盘上,而焊盘则直接焊接在印刷电路板的供电层之上。以采用砖块转换器的系统来说,其θCA热阻值主要取决于印刷电路板供电层的面积,因为热能主要通过导热的方式散发出去,而传导成为主要散热方式的原因是子卡之间的间距越趋缩小,令空气的对流作用受到限制,无法充分散发热量。
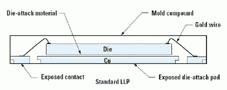
图2:LLP封装的比较
不同封装的比较
芯片底层的供电层只要加设散热孔,便可改善θCA对流热阻。但我们若将焊接LLP封装的焊接层面积加大,散热效果会比改善对流热阻更为显着。只要将LLP封装与采用相同引脚数目及裸片的传统式SO封装加以比较,便可显示 LLP封装这方面的优势。
以 MSOP-8 封装为例来说,这种封装占用15mm2的印刷电路板板面空间,而 LLP-8 封装所占用的板面空间只有9mm2.两者在热阻方面有很大的差别,LLP-8 封装的热阻 (θJC) 只有 40℃/W,而 MSOP-8 的热阻却高达 200℃/W.
免责声明: 凡注明来源本网的所有作品,均为本网合法拥有版权或有权使用的作品,欢迎转载,注明出处。非本网作品均来自互联网,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责。