四元化合物In1-X,GaXAs1-yPy可以通过在InP衬底上外延生长而获得良好的晶格匹配。通过优化艿和y值既可以保证晶格匹配又可以获得需要的禁带宽度。例如In0.53Ga。47As与InP完全匹配,并且其禁带宽度所对应的光谱吸收波长为1.65 ;tm,因此在1~1.65 gm波长范围内InGaAs是广泛使用的材料。与InGaAs相比,四元化合物InGaAsP的制造工艺更复杂,而且对于大多数外延技术而言在生长磷的过程当中难以获得统一组分的InGaAsP,因此InGaAsP的应用不如InGaAs广泛。InGaAs在高温600~700'C下用LPE技术生长,通过掺锡和锌来实现N型和P型掺杂。
支InGaAs光电探测器在1978年就被报道[15],略晚于支InGaAsP光电探测器[16]。这些探测器都可以通过改变组分含量从而达到需要的波长响应。图1所示是一种典型的InGaAsP光电探测器结构,利用异质结构以In0 6qGa0 31As0 66P0 34作为本征吸收层,以In0.7:Ga0.22As0.47P0.53为P型表面入射窗,得到了峰值响应波长为1.36 gm的窄的频谱响应。为了制作方便,一股将这种光电探测器做成台面结构,图2是几种常见的形成台面PIN的方法,包括外延生长,扩散及离子注入等方法。然而这些台面不利于集成,难以实现光电子集成回路(OEIC),因此人们又做出了各种平面结构,这些平面结构类似于图1所示,同时这种平面结构有助于因表面漏电流引起的暗电流。

图1 InGaAsP/InP光电探测器

图2 形成InGaAsP/InP台面结构pn结的不同方法
InGaAsP光电探测器中,表面钝化层、载流子产生复合及隧穿等都会引起暗电流。通过优化表面钝化层可以使表面漏电流密度小到IlA/cm'量级。s.R.Forrestt"J等人指出,在较低偏压流子产生复合对暗电流起主导作用,只有当偏压大于100 V时隧穿电流才变得显著。即使由产生复合引起的小的暗电流也会对光电探测器灵敏度产生不利影响,因此应合理设计结构使暗电流。由于产生复合电流和禁带宽度有关,禁带宽度越小则产生复合电流就越大。为了减小这种产生复合电流应该尽量减少使用窄带隙材料,如图3所示[IS]。它的表面为重掺杂的InGaAs吸收层,重掺杂的InGaAs层使得耗尽区往宽带隙的InP扩展,同时P型InP层的存在也使得同形异质结构中宽带隙一侧的InP成为耗尽层。这样产生复合电流就发生在宽带隙的InP中,因此大大减小了暗电流。
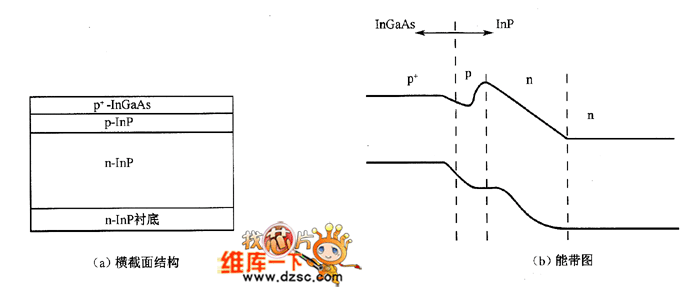
图3具有小暗电流的光电探测器
图4所示是一种双异质结PIN结构InGaAs/lnP光电探测器阝叨,这种双异质结结构进一步减小了扩散电流,台面渐变超晶格减小了载流子捕获效应。因此速度和响应度都得到了提高。

图4 双异质结InGaAs/lnP光电探测器结构示意图
欢迎转载,信息来源维库电子市场网(www.dzsc.com)
免责声明: 凡注明来源本网的所有作品,均为本网合法拥有版权或有权使用的作品,欢迎转载,注明出处。非本网作品均来自互联网,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责。