依靠村田应用半导体(硅)技术开发的独特的集成无源器件和设备(Integrated Passive Devices),可以解决此类需要高可靠性的用途的各种问题。支持引线键合和嵌入的薄型硅电容器,厚度仅为100μm(也能根据要求薄至80μm),对于需要去耦特性的设计人员而言,这是适合嵌入用途的解决方案。
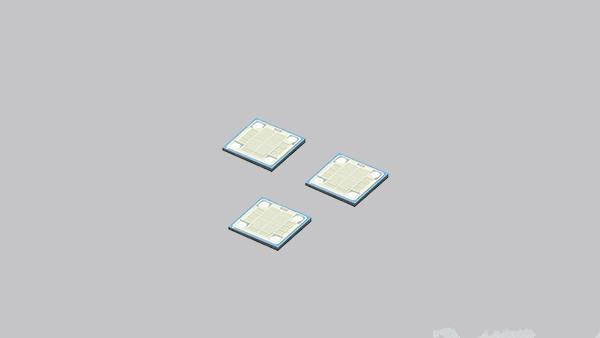
依靠村田应用半导体(硅)技术开发的独特的集成无源器件和设备(Integrated Passive Devices),可以解决此类需要高可靠性的用途的各种问题。支持引线键合和嵌入的薄型硅电容器,厚度仅为100μm(也能根据要求薄至80μm),对于需要去耦特性的设计人员而言,这是适合嵌入用途的解决方案。
EMSC被优化为多层基板封装、刚性/柔性PCB、FR4、陶瓷、玻璃、引线框架或金属薄片的平台。硅电容器技术,提供电容器集成功能(250nF/mm2),与现有解决方案相比,可以更加小型化。村田的技术,与钽和MLCC等替代的电容器技术相比,可靠性达到后者的10倍,不会发生开裂现象。半导体(硅)技术,在工作电压和工作温度的整个范围内,静电容量极其稳定,并稳定保持高绝缘电阻。这项以硅为基础的技术符合RoHS标准,可以进行无铅回流封装。
免责声明: 凡注明来源本网的所有作品,均为本网合法拥有版权或有权使用的作品,欢迎转载,注明出处。非本网作品均来自互联网,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责。