从硅圆片制成半导体产品,就是根据所需要的功能去设计芯片,然后将芯片制成晶圆。而晶圆是由芯片反复排列形成,细看已完成的晶圆时,可以看到许多小格子状的结构,一个小格子就代表一个芯片。
半导体产品按大工序可分为前道工艺(又称前端工艺)和后道工艺(又称后端工艺)。晶圆的制作工艺中也会细分前端和后端,通常是CMOS制程工序属于前端,而其后的金属布线工序属于后端。
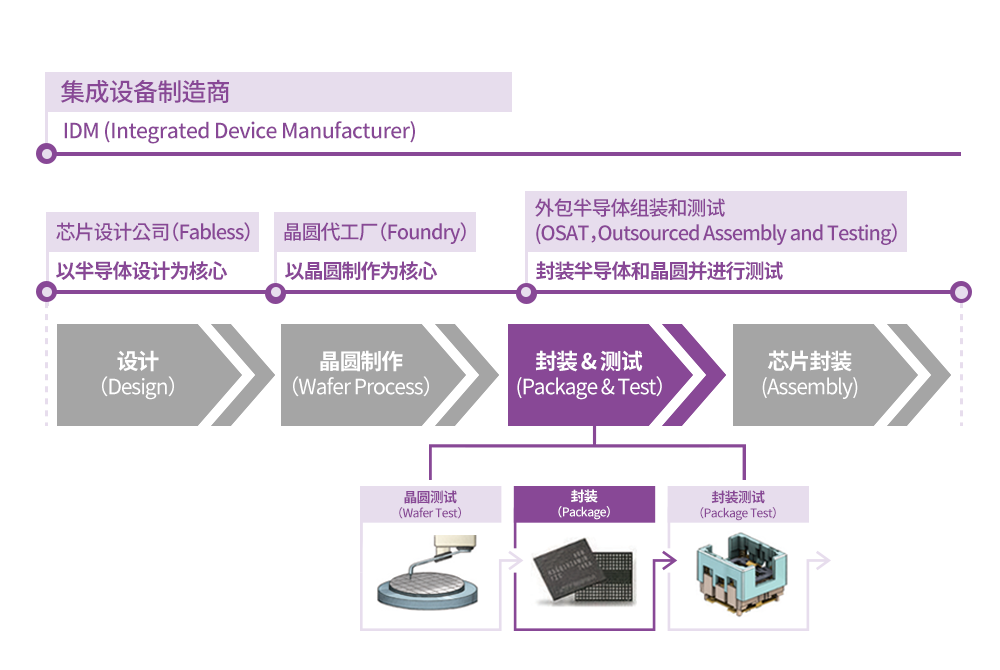
如图1所示,封装和测试工艺的di一步就是晶圆测试。封装后,再对封装进行测试。
半导体测试的主要目的之一就是防止不良产品出厂。一旦将不良产品提供给客户,客户对我们的信任就会大打折扣,影响工厂及公司的信誉。因此,我们必须在产品出厂前对其进行细致的全面检测。半导体测试须根据产品的各种特性,对其各参数进行测试,确保产品的品质和可靠度。这些测试不仅会延后产品的出厂日期,还会提高产品的制造成本和人工费,因此,众多测试工程师正致力于减少测试时间和测试参数。
测试的种类

表1: 测试分类
依据不同的测试对象,测试工艺可分为晶圆测试和封装测试。而根据不同的测试参数,分为温度、速度和运作模式测试等三种类型。
①温度测试
在高温测试中,对产品施加的温度比产品规格所示温度范围的上限高出10%;在低温测试中,施加温度比规格下限低10%;而恒温测试的施加温度一般为25℃。在实际使用中,半导体产品会在各种不同的环境中运作,因此必须测试产品在不同温度下的运作情况以及其温度裕度(Temperature Margin)。以半导体存储器为例,高温测试范围通常为85~90℃,低温测试范围为-5~-40℃。
②速度测试
he心测试主要测试样品的he心运作是否能实现原计划的目标功能。以半导体存储器为例,由于其主要功能是信息的存储,测试的重点便是有关信息存储单元的各项参数。而速率测试是测量样品的运作速率是否能按照目标速度运作。随着对高速运转半导体产品需求的增加,速率测试目前正变得越来越重要。
③运作模式测试
根据半导体的性能,运作模式测试细分为三种。1.直流测试主要验证直流电流和电压参数;2.交流测试(AC Test)验证交流电流的规格,包括产品的输入和输出转换时间等运作特性;3.功能测试则验证其逻辑功能是否正确运作。以半导体存储器为例,功能测试就是指测试存储单元(Memory cell)与存储器周围电路逻辑功能是否能正常运作。
晶圆测试
晶圆测试是半导体后端工艺区分良品与不良品的di一道工序,检验这些芯片的特性和品质。一般来讲,晶圆测试依次按照“电气参数监控(EPM) → 晶圆老化(Wafer Burn in) → 测试 → 维修(Repair) → 测试”顺序进行。
完成封装的产品会形成像锡球(Solder Ball)一样的引脚(Pin),利用这些引脚可以轻而易举完成与测试机的电气连接。如果在晶圆状态下,就需要用探针卡连接两者。
在图2中探针卡是被测晶圆和测试机的接口,卡上的探针将测试机通讯接口和晶圆的焊盘连接起来,卡内还布置了很多连接探针与测试机的连接线材。将探针卡固定在测试头上,晶圆探针台通过使探针卡与晶圆焊盘点精准接触,完成测试。
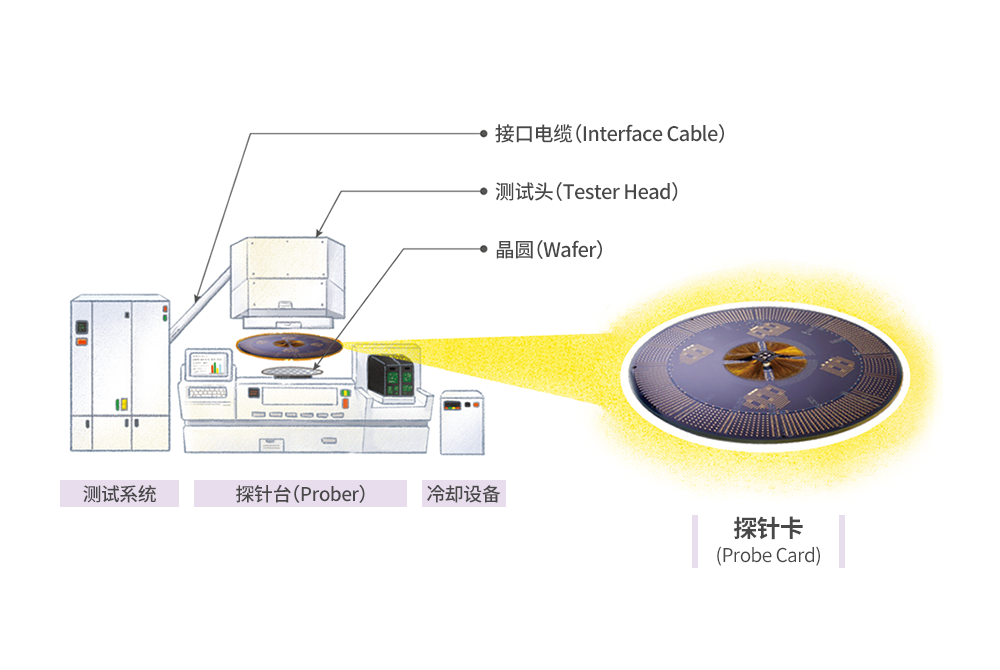
图2 : 晶圆测试系统模式图
探针卡要根据被测芯片的焊盘布局和晶圆芯片排布制作,探针需与被测晶圆焊盘布局要一致。还要按照芯片排列,反复排布探针。在实际操作中,探针卡需要反复接触晶圆2~3次,才能测试晶圆的所有芯片。
①电气参数监控(EPM,Electrical Parameter Monitoring)
晶圆测试可以筛选出不良产品,又可以反馈正在研发或量产中的产品缺陷,从而进行改善。而电气参数监控的主要目的是通过评价分析产品单位元件的电气特性,对晶圆的制作工序提供反馈。从测试的角度来看,就是利用元件的电学性能提取直流参数(Parameter),并监控各单位元件的特性。
②晶圆老化(Wafer Burn in)
“老化”的目的就是为识别产品的潜在缺陷,提前发现产品的早期失效状况。晶圆老化是在晶圆产品上施加温度、电压等外界刺激,剔除可能发生早期失效的产品的过程。
③测试
在晶圆老化测试剔除早期失效产品后使用探针卡进行晶圆测试。其主要目的包括:提前筛选出不良芯片、事先剔除封装/组装过程中可能产生的不良产品并分析其原因、提供工序反馈信息,以及通过晶圆级验证提供元件与设计上的反馈等。
④维修(Repair)
在晶圆测试中筛选出的部分不良单元,通过维修算法用备用单元替换。维修工序可以提高产品的良率,因此,在设计半导体存储器时,会考虑备用单元的制作,并根据测试结果以备用单元取代不良单元。当然,制作备用单元就意味着要消耗更多的空间,这就需要加大芯片的面积。所以不可能制作取代所有不良内存的充足的备用单元。要综合考虑工艺能力,选择可以zui大程度地提升良率的数量。为测试这些备用单元是否能正常工作,以及芯片能否成为符合规格的良品,在维修工序后,必须重新进行yi次晶圆测试。
封装测试
在晶圆测试中被判定为良品的芯片,经封装工序后需要再进行封装测试,因为这些芯片在封装工序中有可能发生问题。而且,晶圆测试同时测试多个芯片,测试设备性能上的限制可能导致其无法充分测试目标参数。与此相反,封装测试以封装为单位进行测试,对测试设备的负荷相对较小,可以充分测试目标参数,从而选出符合规格的良品。
老化测试(Test During Burn In,TDBI)
“老化”是为了提前发现产品的早期失效,向晶圆产品施加温度、电压等外界刺激的工序。这一工序既可在晶圆测试中进行,也可在封装测试阶段进行。封装后实施的“老化”被称为老化测试。大部分半导体产品在晶圆和封装测试均进行老化测试,以便更加全面地把握产品的特性,寻找缩减老化时间和工序数量的条件。所以,老化对于量产来说是一道zui有效的工序。
外观(Visual)检测
完成所有测试后,需通过激光打标把测试结果和速率特性(尤其是需要区分速率时)记录在产品封装的表面。经封装测试和激光打标后,将良品装入封装托盘,产品即可出厂了。当然,在出厂前,还要进行zui后一道测试——外观测试,以剔除外观上的缺陷。外观检测主要查看是否有龟裂、打标错误、装入错误的托盘等问题;锡球方面主要检查球是否被压扁,或球是否脱落等问题。